现在的位置:主页 > 产品中心 > 封装材料 > Brewer晶圆级封装 > WaferBOND® HT-10.11 and HT-10. > WAFERBOND® HT-10.11 AND HT-10.12 MATERIALS
WAFERBOND® HT-10.11 AND HT-10.12 MATERIALS

WAFERBOND HT-10.11和HT-10.12 MATERIALS
WaferBOND HT-10.11和HT-10.12临时焊接材料支持使用标准半导体设备对超薄晶圆进行后端(BEOL)处理。
WaferBOND HT-10.11和HT-10.12材料是为微机电系统和三维晶圆级封装应用的临时晶圆键合解决方案开发的有机涂层。WaferBOND HT-10.11材料能够通过衬底减薄和背面标准光刻处理实现有效的结合和支撑,通过利用有效的结合和随后的热滑动、化学*、机械**、或激光**剥离,厚度< 75 μm。WaFerBond HT-10.12材料能够实现热滑动剥离,膜厚≥ 75 μm。这些材料专门针对薄晶片处理(TWH)、硅通孔(TSV)显露和再分布层(RDL)产生或高达250℃的工艺开发。
*如果在切割后释放的话,化学释放剥离方法需要穿孔的载体晶片或小的管芯尺寸,
**机械和激光剥离方法需要相容的剥离材料
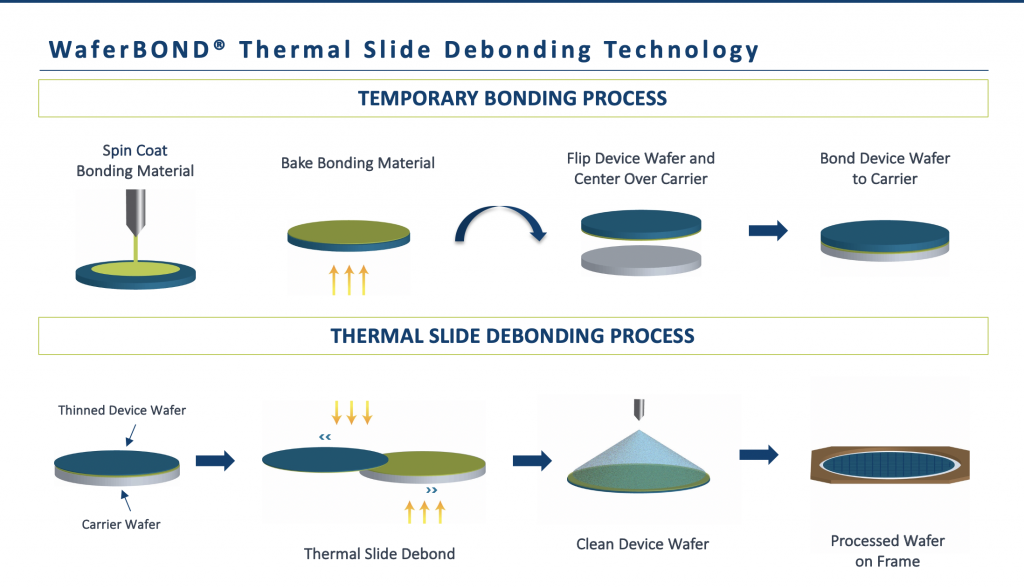
优点:
利用标准BEOL技术和工具实现超薄晶片处理
在减薄后帮助创建互连(RDL层)
保护器件免受化学降解和物理破坏
粘合材料可从器件晶片上完全移除而不会损坏
可用于各种剥离方法(化学剥离、热滑动、机械或激光)
WaferBOND HT-10.11和HT-10.12材料旋转速度曲线:
使用这些粘合材料,您可以:
在高达250℃的温度下处理超薄晶圆
保护晶圆边缘免于碎裂
保护电路免受苛刻的化学蚀刻剂侵蚀
在最终变薄的晶圆上提供光滑表面的无空隙界面
WaferBOND HT-10.11和HT-10.12临时焊接材料支持使用标准半导体设备对超薄晶圆进行后端(BEOL)处理。
WaferBOND HT-10.11和HT-10.12材料是为微机电系统和三维晶圆级封装应用的临时晶圆键合解决方案开发的有机涂层。WaferBOND HT-10.11材料能够通过衬底减薄和背面标准光刻处理实现有效的结合和支撑,通过利用有效的结合和随后的热滑动、化学*、机械**、或激光**剥离,厚度< 75 μm。WaFerBond HT-10.12材料能够实现热滑动剥离,膜厚≥ 75 μm。这些材料专门针对薄晶片处理(TWH)、硅通孔(TSV)显露和再分布层(RDL)产生或高达250℃的工艺开发。
*如果在切割后释放的话,化学释放剥离方法需要穿孔的载体晶片或小的管芯尺寸,
**机械和激光剥离方法需要相容的剥离材料
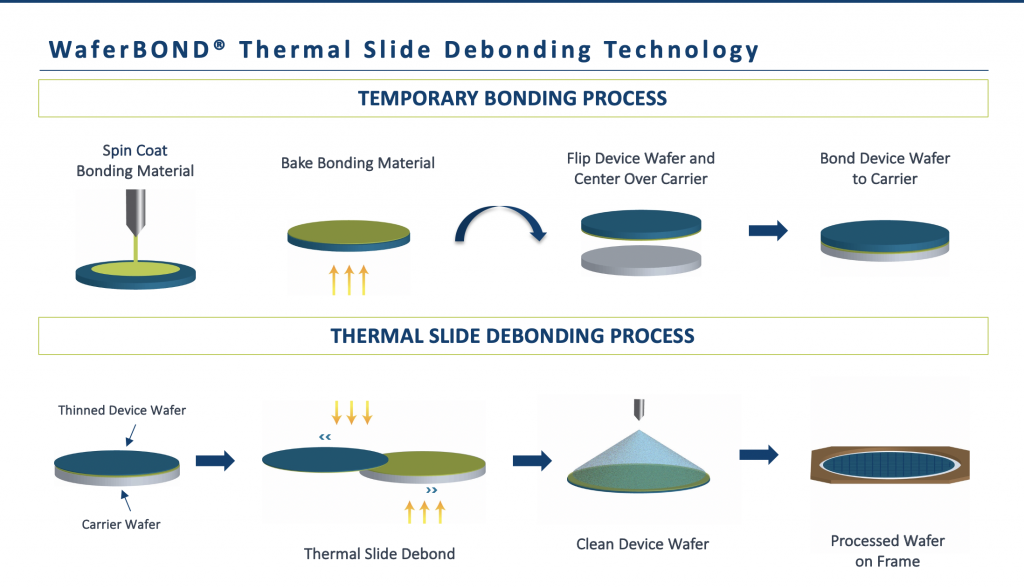
| Properties | Wax | WaferBOND® HT-10.11 or HT-10.12 Material |
| Thickness Range | ~ 10 – 35 µm | 20 µm – 130 µm |
| Coating Throughput | Requires multiple coats | Single-coat process |
| Bonding Temperature Range | 95°C – 110°C | 130°C – 180°C |
| Debonding Temperature Range | 95°C – 110°C | 150°C – 200°C |
| Thermal Stability Temperature Range | < 120°C | ≤ 250°C |
优点:
利用标准BEOL技术和工具实现超薄晶片处理
在减薄后帮助创建互连(RDL层)
保护器件免受化学降解和物理破坏
粘合材料可从器件晶片上完全移除而不会损坏
可用于各种剥离方法(化学剥离、热滑动、机械或激光)
WaferBOND HT-10.11和HT-10.12材料旋转速度曲线:
使用这些粘合材料,您可以:
在高达250℃的温度下处理超薄晶圆
保护晶圆边缘免于碎裂
保护电路免受苛刻的化学蚀刻剂侵蚀
在最终变薄的晶圆上提供光滑表面的无空隙界面


